Her türlü malzemenin faz analizleri X-ışınları tekniği ile gerçekleştirilebilmektedir. Malzemenin içeriğinde bulunan fazların tespitinin yanı sıra miktarsal olarak bu fazların oranları, yapılarındaki kalıntı gerilmeler de bu laboratuvarda bulunan X-ışınları difraktometre cihazı ile tespit edilir. Bu cihaza adapte edilmiş normal ve gazaltı koşullarda 2000 °C gibi yüksek sıcaklıklara kadar ölçüm alabilen yüksek sıcaklık kamarası, yaklaşık 300.000 adet organik ve inorganik fazların kristalografi ve kırınım (difraksiyon) bilgilerinin yer aldığı bir veri tabanı (ICDD-International Centre for Diffraction Data) mevcuttur. Aynı laboratuvarda İSTKA/2012/BİL/28 projesi çerçevesinde satın alınan Gaz Piknometresi ve Taramalı Elektron Mikroskobu (SEM) cihazları da bulunmaktadır. Faz piknometersi cihazı ile her türlü toz ve bünye (bulk) malzemenin gerçek yoğunluğu ölçülür. SEM cihazındaen üst 40,000 büyütmede İkincil Elektron Görüntüleme (Secondary Electron Imaging- SEI) ile Geri Saçılmış Elektron Görüntüleme (Back Scatterred Electron – BSE) modlarında mikroyapısal karakterizasyon deneylerinin yanı sıra, Enerji Dağılım Spektroskobu (EDS) sayesinde kimyasal spektral element analizi yapılabilmektedir.
Cihazlar
XRD (Bruker™ AXS D8 Advance)
Bilinen tüm elementlerin karakteristik X-ışınları çizgileri Siegbahn ve arkadaşları tarafından oldukça hassas ölçülmüş ve kayda alınmıştır. Yani tüm elementlerin en güçlü K ve L çizgi değerleri X-ışınları difraksiyona yönelik kitaplarda mevcuttur. Sürekli spektrum, X-ışınlarının hızla çarpması sonucu aniden yavaşlaması sonucu oluşur. Buna karşın, karakteristik spektrumun oluşumuna hedef malzemenin atomları yol açar.
Herhangi bir kristalde atom düzlemlerinden saçılan X-ışınlarının artı girişim (positive interference) yapması sonucu difraksiyon olayı meydana gelir. Düzlemler arası mesafesi dhkl olan düzlemlerdeki artı girişim şartı yani difraksiyon Bragg kanunu olarak tanımlanır :
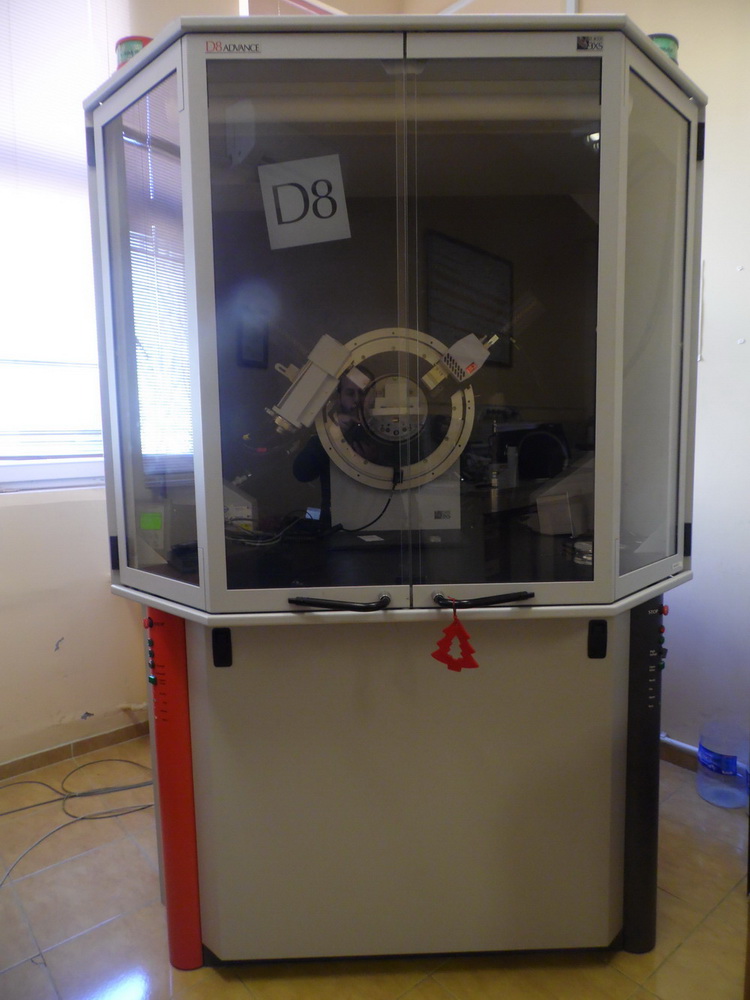

Dalga boyu ( λ) 0,05 ile 0,2 nm arasında değişen ve paralel bir hüzme olarak numunenin üzerine çarpan X-ışınları, Bragg kanununa ( λ= 2dsinϴ) göre numunenin bazı kristal düzlemlerinden difraksiyona uğrar. Difraksiyona uğramış olan X-ışınlarının şiddeti (intensity – I) difraksiyon açısının (2ϴ) ve numunenin oryantasyonunun fonsiyonu olarak ölçülür. Bu şekilde oluşan difraksiyon paterni numunedeki kristal fazları ile deformasyonu belirlemek ve küçük kristal tanelerinin boyutları ve oryantasyonları gibi yapısal özelliklerini ortaya çıkarmak amacıyla kullanılır. Aynı zamanda difraksiyon paterni yapı kusurlarının karakterizasyonunda da kullanılır. İnce filmler ve nano yapılardan yapısal ve fiziksel bilgi toplayabilmek amacıyla bazı X-ışınları cihazları ve yöntemleri difraksiyona uğramış X-ışınları şiddetlerini abartmak (maksimize etmek) amacına uygun olarak tasarlanmıştır.
X-ışınları difraksiyonu (XRD) malzeme yapısında mevcut kristal fazların belirlenmesinde, bu fazların yapısal özelliklerinin (deformasyon, iç gerilmeler, tercihli yönlenme, kristal tane boyutu, hata yapısı) ölçülmesinde kullanılan güçlü bir yöntemdir. XRD ince filmlerin ve çok katmanlı yapıların kalınlıklarının belirlenmesinde ve amorf malzemelerin (polimer dahil) atomsal düzlemlerinin belirlenmesinde de kullanılır. XRD atomsal mesafelerin ölçümünde yüksek hassasiyet sağlar ve ince filmlerdeki deformasyon ölçümleri için kullanılan ana yöntemdir. XRD temassız ve tahribatsız bir ölçüm yöntemidir ve bundan ötürü in-situ analizler için biçilmiş kaftandır.
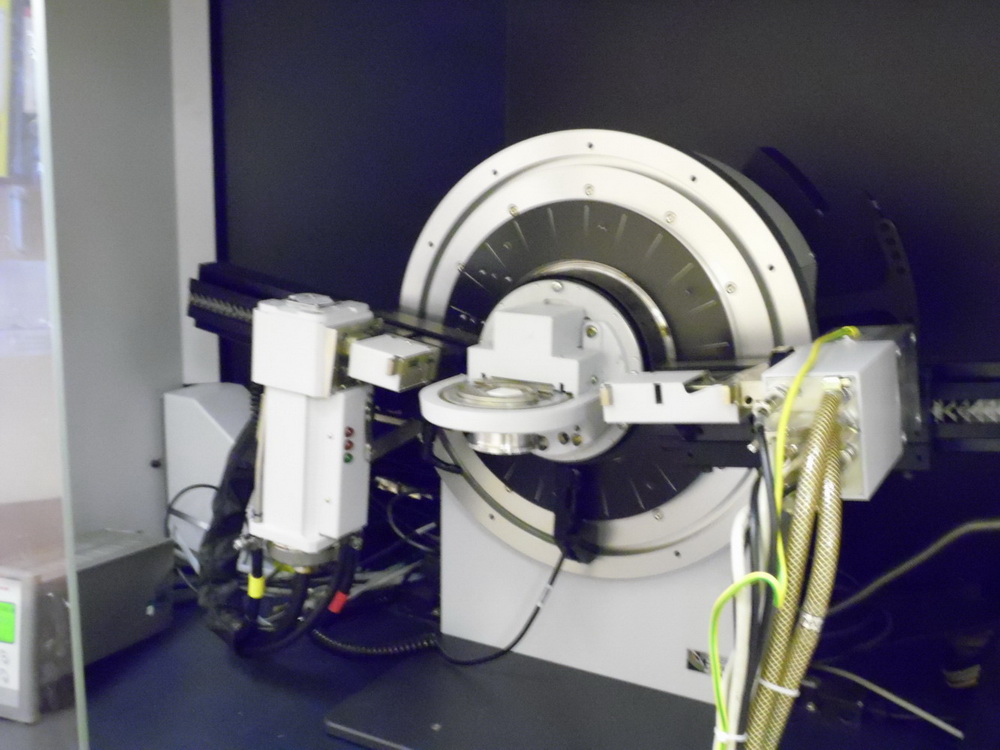
X-ışınları spektrometre cihazları difraksiyon analizlerinde kullanılabilir. Eğer bilinen ve sabit radyasyon dalga boyu olan X-ışınları bilinmeyen kristal düzlemler arası mesafeleri belirlemek amacıyla kullanılırsa, bu yönteme Difraktometre yöntemi denilir. Eğer bilinen düzlemleri olan kristaller kullanılıp bilinmeyen dalga boylarını belirlemek amacıyla kullanılırsa, bu yönteme Spektrometre adı verilir. Difraktometre yöntemi her zaman sabit dalgaboylu yani monokromatik radyasyon altında gerçekleştirilir. Difraktometre analizleri tek veya çok kristal (polikristal) numuneler üzerinde gerçekleştirilir.
SEM (Taramalı Elektron Mikroskobu)
Taramalı elektron mikroskobisi (SEM) oldukça bir yüksek vakumda (UHV), yüksek vakumda (HV) ve düşük vakumda (LV) her türlü malzemenin (polimer, cam, seramik, metal ve kompozit) karakterizasyon çalışmalarında kullanılan bir yöntemdir. SEM yönteminin ve cihazının uygulama ve hitap ettiği alanlar yaşam bilimlerinden, polimer jeoloji, malzeme bilimi ve teknolojileri, elektronik endüstrileri ile arkeoloji çalışmalarına kadar son derece geniş bir yelpazeyi kapsamaktadır.


SEM cihazının oldukça yüksek odaklama derinliği (depth of focus) vardır. Odaklama derinliği numunede var olan tüm yükselti ve çukurların aynı anda odaklanmış olarak net görünmesi anlamına gelmektedir. Işık mikroskobu ile ulaşılabilen büyütme (magnification) değerlerinde yani en fazla 1000X büyütmeler için, SEM cihazının odak derinliği optik mikroskobunkinden yaklaşık 100 kat fazladır. Ortaya çıkışından beri, SEM cihazının müthiş başarısının sırrı bu oldukça yüksek odaklama derinliği, mükemmel görüntü kontrastı özelliği, oldukça kolay numune hazırlama özelliği ve bu cihaza eklenebilecek X-ışınları analitik cihazlarla kalitatif ve kantitatif element analizlerin yapılabilmesi gerçeğinde yatmaktadır.
Micromeritics AccuPyc-II-1340 Piknometre
Gaz piknometrisi, gerçek hacim ve yoğunluk elde etmek için en güvenilir tekniklerden biri olarak kabul edilmektedir. Bu teknik, hacmi ölçmek için gaz yer değiştirme yöntemini kullandığı için tahribatsızdır. Yer değiştirme ortamı olarak helyum veya azot gibi inert gazlar kullanılır. AccuPyc II 1340 Serisi Piknometreler, çok çeşitli tozlar, katılar ve bulamaçlar üzerinde yüksek hızlı, yüksek hassasiyetli hacim ölçümleri ve gerçek yoğunluk hesaplamaları sağlayan hızlı, tam otomatik piknometrelerdir.
